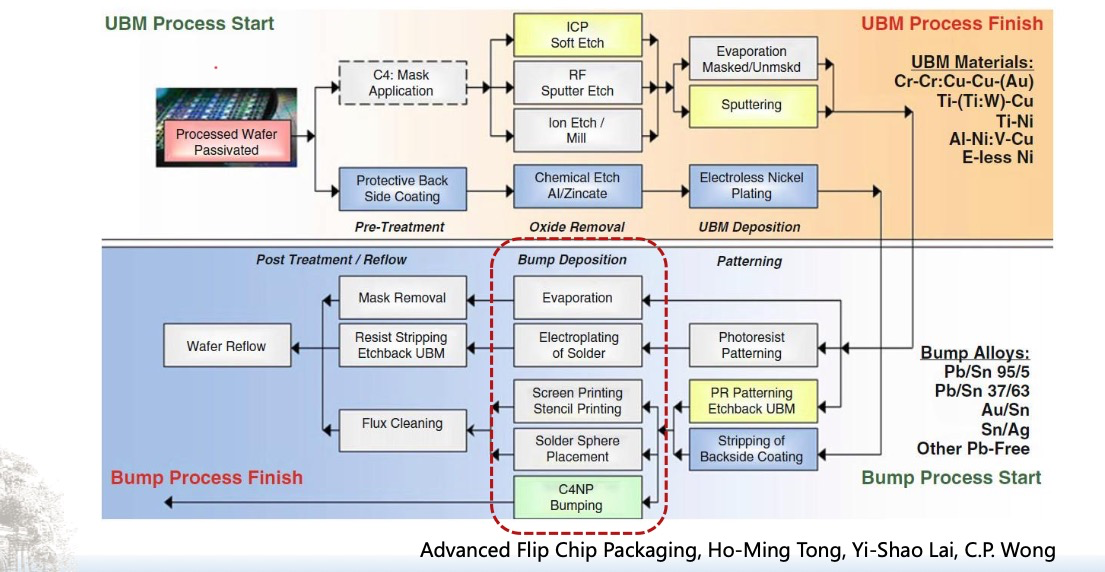
UBM(Under Bump Metallization)与Bump(焊球)形成工艺流程。我们可以将整张流程图分为三大阶段来理解:
🔧 一、UBM(Under Bump Metallization)工艺流程(黄色区域)
目的:在芯片焊盘上形成一个用于支持焊球连接的金属结构,具备良好的润湿性、电导性、粘附性与阻挡性。
🔹流程步骤:
C4 Mask Application
应用光刻掩膜,界定UBM区域。Oxide Removal(氧化物去除)
采用干法刻蚀(ICP、Sputter、Ion Etch)或湿法(化学蚀刻)去除表面氧化物,以提升UBM附着力。UBM Deposition(UBM沉积)
Sputtering / Evaporation 蒸镀/溅射:沉积多层金属,如:
- 粘附层:Cr, Ti, TiW
- 阻挡层:Ni, W, V
- 润湿层:Cu, Au, Sn
Electroless Plating(化学镀):无电电镀 Ni,用于简化制程。
常见UBM金属系统示例:
Cr–Cu–Cu–Au、Ti–Ni–Cu、Al–Ni–V–Cu
🟡 二、Bump形成工艺(红框区域)
目的:在UBM上生成具有高度机械、电性可靠性的微小焊球,供Flip Chip互连使用。
🔹Bump Deposition 方法(可选):
Evaporation 蒸发沉积(如 E3 工艺)
精准控制共晶金属厚度,适合高密度焊球。Electroplating 电镀
最常用方式,控制合金比例(如 Pb/Sn 95/5,Sn/Ag 等)。Screen Printing / Stencil Printing
通过网板印刷焊膏后回流焊接成球,适合低密度封装。Solder Sphere Placement 球体放置
使用机械方式将标准尺寸焊球放置在焊盘上,再进行回流熔接。C4NP(Controlled Collapse Chip Connection New Process)
是 IBM 开发的新工艺,利用无助焊剂、液态预置锡球技术,实现更洁净、更稳定的焊接连接。
🔁 三、后处理 Reflow & 清洗(蓝色区域)
🔹Post Treatment / Reflow:
Wafer Reflow
在精控温度下将焊料熔融、球化并与UBM良好润湿。Mask Removal / PR剥离 / Etchback UBM
去除光刻胶、刻蚀多余UBM金属。Flux Cleaning 助焊剂清洗
去除有机残留,避免信号污染或可靠性问题。
🧪 常用Bump材料(右下角列出)
| 合金 | 说明 |
|---|---|
| Pb/Sn 95/5 | 高熔点,共晶温度~300°C |
| Pb/Sn 37/63 | 共晶焊料,熔点183°C |
| Au/Sn | 高可靠性金属系统,常用于光电器件 |
| Sn/Ag | 无铅封装主流选项 |
| Pb-Free | 符合RoHS环保要求的新型焊料体系 |
🧭 总结关键要点:
- UBM 是封装成功的基础:决定焊球附着性与长期可靠性;
- Bump 工艺多样化:可根据密度、成本、可靠性需求灵活选择;
- E3 蒸发型工艺 / 电镀工艺 是高端 Flip Chip 封装首选;
- C4NP 技术 开启助焊剂替代的新方向;
- 整体流程结合了光刻、蚀刻、薄膜沉积、回流焊等多项微电子制造工艺。